
前不久,日本FUJIMI披露了公司CMP開(kāi)發(fā)部關(guān)于氧化鋯顆粒在拋光中的研究文章。為便于相關(guān)從業(yè)者更好了解和學(xué)習(xí)相關(guān)內(nèi)容,小編結(jié)合相關(guān)應(yīng)用背景對(duì)研究論文進(jìn)行翻譯總結(jié),希望讀者朋友能有一定收獲。
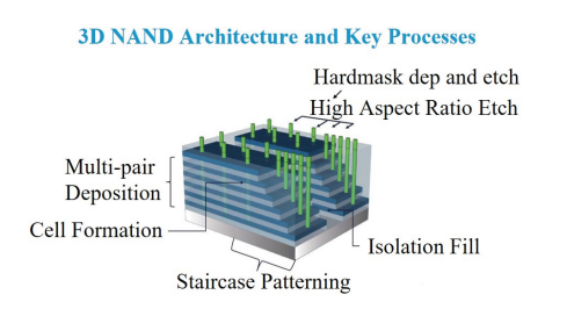
3D NAND結(jié)構(gòu)示例
1、研究背景
在高性能半導(dǎo)體器件(尤其是3D NAND閃存)的制造中,深孔或深溝槽的高深寬比刻蝕工藝,要求采用與底層材料(如氧化物、硅等)具有極高的刻蝕選擇比的硬掩模材料。碳膜(尤其是類(lèi)金剛石碳或非晶碳)具有高硬度、高模量,能承受后續(xù)工藝中的機(jī)械和熱負(fù)荷,并且碳膜在特定波長(zhǎng)下透明或半透明,便于在光刻對(duì)齊過(guò)程中進(jìn)行精確的套刻對(duì)準(zhǔn);碳膜不含金屬成分,對(duì)大多數(shù)化學(xué)試劑具有良好的抵抗性,在濕法清洗或刻蝕過(guò)程中不易被破壞……除了上述有利因素,碳膜對(duì)于使用二氧化硅或氧化鈰顆粒的CMP漿料難以有效拋光,本文中提到過(guò)去的解決方案是添加氧化劑或金屬絡(luò)合劑以增強(qiáng)拋光效果,但這些添加劑會(huì)帶來(lái)漿料穩(wěn)定性差、難以清洗、可能損傷設(shè)備等問(wèn)題。因此,本次研究探索使用氧化鋯顆粒作為新型磨料,通過(guò)機(jī)械化學(xué)反應(yīng)在拋光過(guò)程中與碳膜形成共價(jià)鍵(Zr–C),從而增強(qiáng)碳膜的去除率。

氧化鋯與碳表面相互作用結(jié)構(gòu)示意
2、實(shí)驗(yàn)重點(diǎn)
據(jù)研究文章,本次選用了三種不同晶體結(jié)構(gòu)(混合A、立方B、單斜C)的氧化鋯顆粒,通過(guò)XPS分析釔濃度間接評(píng)估氧空位含量,使用納米壓痕法測(cè)量顆粒的彈性模量,并且通過(guò)干式搖動(dòng)實(shí)驗(yàn)?zāi)M機(jī)械化學(xué)反應(yīng),使用XPS分析Zr–C鍵的形成率,以及在相同條件下比較三種氧化鋯漿料與二氧化硅漿料對(duì)碳膜的拋光速率。

三種樣品的規(guī)格和SEM
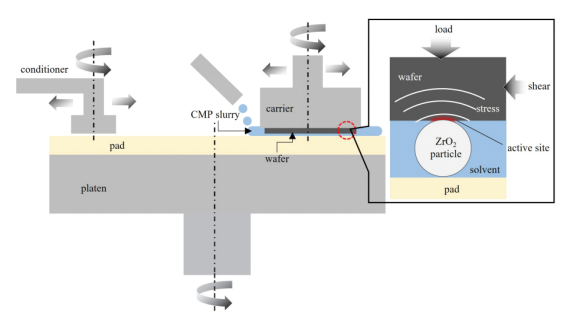
CMP測(cè)試系統(tǒng)示意
基于拋光速率與Zr–C形成率呈正相關(guān),因此實(shí)驗(yàn)其實(shí)是研究氧化鋯顆粒的氧空位含量和彈性模量與Zr–C形成率之間的聯(lián)系,結(jié)論是:氧空位含量與Zr–C形成率無(wú)明顯相關(guān)性,彈性模量卻高度相關(guān)——即使用高彈性模量的氧化鋯顆粒可在拋光過(guò)程中有效促進(jìn)Zr–C共價(jià)鍵的形成,從而顯著提高碳膜的拋光速率(樣品A最高速率是二氧化硅漿料的15倍);將化學(xué)活性極高的氧化鋯顆粒引入CMP漿料,有可能無(wú)需添加氧化劑或金屬絡(luò)合劑,即可實(shí)現(xiàn)高效、環(huán)保的CMP工藝,有助于降低漿料消耗和后續(xù)清洗負(fù)擔(dān)。
粉體圈 YUXI

作者:YUXI
總閱讀量:222供應(yīng)信息
采購(gòu)需求
