
隨著現代電子技術的飛速發展,電子設備小型化和集成化趨勢愈來愈明顯,同時工作頻率和功率密度也顯著增加,給電子系統的熱管理帶來了前所未有的挑戰。封裝基板作為半導體器件中的重要組成部分,除了能夠搭載芯片、并為芯片提供電連接、保護,還起著連接內外散熱通道的關鍵作用。
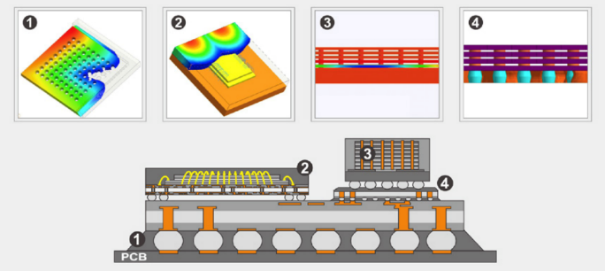
Dk介電常數、Df高頻損耗、CTE膨脹系數是通訊封裝電子陶瓷的核心指標。低溫共燒陶瓷基板(LTCC)一般采用微晶玻璃系、陶瓷+玻璃復合系、非晶玻璃系等具有低燒結溫度的介質陶瓷材料,具有導通電阻低、制造成本低、熱膨脹系數低、介電常數低且易調整、可埋置無源器件、高頻特性優良、可制作線寬低至50μm的精細電路的優點,滿足高頻、低損耗、高速傳輸、小型化等的封裝要求。
在芯片封裝過程中,過去以硅作基板發展了硅通孔技術(Through-Silicon Via,TSV),通過在芯片和芯片之間、晶圓和晶圓之間制作垂直導通,實現芯片之間互連。相應的,以玻璃和陶瓷作為基板,則發展了玻璃通孔技術(Through-Glass Via,TGV)和陶瓷通孔技術(Through Ceramic Via,TCV)。以上都涉及粉料、微孔技術以及特種加工設備,具有跨學科、技術難度高的特點。AR值高于10:1的微孔互聯技術在陶瓷基HDI以及內外層電子電路制造中,亟待產學研界的聯合合作,在產能和良率上實現突破。

南京麥德材料有限公司成立于2019年8月,是南京市秦淮區引進的高科技公司,主要專注于陶瓷材料及其立體線路的應用開發,結合激光技術實現先進制造、材料改性及防護處理。公司和多所高等院校以及研究機構有深層次合作,擁有自主知識產權30余項,能夠為客戶提供優質的從材料到最終電子電路產品的一體化解決方案和服務。
2025年5月26日-28日,粉體圈將在廣州美麗豪酒店舉辦“CAC2025廣州先進陶瓷論壇暨展覽會”。在5月27日下午的“電子陶瓷”分論壇上,來自南京麥德材料有限公司的總經理鄧文將分享題為“陶瓷和玻璃材料及其基板中微孔互聯技術”的報告。報告介紹了陶瓷-玻璃復合材料作為芯片基板在散熱、介電損耗等方面的優勢,以及公司在陶瓷基板通孔技術上的研發成果。相信這份結合技術解析和產業洞察的精彩分享,一定能為半導體用電子陶瓷的研發、設備制造提供新的思路與實踐指南。
報告人簡介

鄧文,1990年畢業于南昌航空工業學院金屬腐蝕與防護專業,1996年碩士畢業于天津大學研究生院應用化學專業,先后在湘潭工學院(現湖南科技大學),美國杜邦公司,德國LPKF公司和比亞迪公司工作,歷任講師,項目經理,經理,廠長,總監等職。2012年創立三維立體線路公司,并完成科技部和財政部“中小型企業創新基金”支持。2019年8月創立南京麥德材料有限公司,任執行董事、總經理。
CAC2025先進陶瓷論壇

作者:粉體圈
總閱讀量:500